“BGA焊接/BGA拆卸/BGA返修”参数说明
| 加工方式: | 任何方式 | 无铅制造工艺: | 提供 |
| 免费打样: | 支持 | 型号: | 芯片 |
| 规格: | 片 | 商标: | 片 |
| 包装: | 真空 | 产量: | 10000 |
“BGA焊接/BGA拆卸/BGA返修”详细介绍
◆BGA返修台返修機返修BGA的基本步骤与返修传统SMD的步骤相同:
为每个元件建立一条温度曲线;
b:BGA热风返修工作站拆除元件;
c:( J去除残留焊膏并清洗这一区域;
d贴装新的BGA器件。在某些情况下,BGA器件可以重复使用;
e回流焊。
当然,这三种主要类型的BGA,都需要对工艺做稍微不同的调整。对于所有的BGA,温度曲线的建立都是相当重要的。不能尝试省掉这一步骤。如果技术人员没有合适的工具,而且本身没有受过专门的培训,就会发现很难去掉残留的焊膏。过于频繁地使用设计不良的拆焊编织带,再加上技术人员没有受过良好的培训,会导致基板和阻焊膜的损坏。
◆建立温度曲线
与传统的SMD相比,BGA对温度控制的要求要高得多。必须逐步加热整个BGA封装,使焊接点发生回流。
如果不严格控制温度、温度上升速率和保持时间(2℃/s~3℃/s),回流焊就不会同时发生,而且还可能损坏器件。为拆除BGA而建立一条稳定的温度曲线需要一定的技巧。设计人员并不是总能得到每个封装的信息,尝试方法可能会对基板、周围的器件或浮起的焊盘造成热损坏。
具有丰富的BGA返修经验的技术人员主要依靠破坏性方法来确定适当的温度曲线。在PCB上钻孔,使焊点暴露出来,然后将热电偶连接到焊点上。这样,就可以为每个被监测的焊点建立一条温度曲线。技术数据表明,印制板温度曲线的建立是以一个布满元件的印制板为基础的,它采用了新的热电偶和一个经校准的记录元件,并在印制板的高、低温区安装了热电偶。一旦为基板和BGA建立了温度曲线,就能够对其进行编程,以便重复使用。
利用一些热风返修系统,可以比较容易地拆除BGA。通常,某一温度(由温度曲线确定)的热风从喷嘴喷出,使焊膏回流,但不会损坏基板或周围的元件。喷嘴的类型随设备或技术人员的喜好而不同。一些喷嘴使热风在BGA器件的上部和底部流动,一些喷嘴水平移动热风,还有一些喷嘴只将热风喷在BGA的上方。也有人喜欢用带罩的喷嘴,它可直接将热风集中在器件上,从而保护了周围的器件。拆除BGA时,温度的保持是很重要的。关键是要对PCB的底部进行预热,以防止翘曲。拆除BGA是多点回流,因而需要技巧和耐心。此外,返修一个BGA器件通常需要8到10分钟,比返修其它的表面贴装组件慢。
◆)清洗贴装位置
贴装BGA之前,应清洗返修区域。这一步骤只能以人工进行操作,因此技术人员的技巧非常重要。如果清洗不充分,新的BGA将不能正确回流,基板和阻焊膜也可能被损坏而不能修复。
大批量返修BGA时,常用的工具包括拆焊烙铁和热风拆焊装置。热风拆焊装置是先加热焊盘表面,然后用真空装置吸走熔融焊膏。拆焊烙铁使用方便,但要求技术熟练的人员操作。如果使用不当,拆焊烙铁很容易损坏印制板和焊盘。
在去除残留焊膏时,很多组装者喜欢用除锡编织带。如果用合适的编织带,并且方法正确,拆除工艺就会快速、安全、高效而且便宜。
虽然使用除锡编织带需要一定的技能,但是并不困难。用烙铁和所选编织带接触需要去除的焊膏,使焊芯位于烙铁头与基板之间。烙铁头直接接触基板可能会造成损坏。焊膏-焊芯BGA除锡编织带专门用于从BGA焊盘和元件上去除残留焊膏,不会损坏阻焊膜或暴露在外的印制线。它使热量通过编织带以最佳方式传递到焊点,这样,焊盘发生移位或PCB遭受损坏的可能性就降至最低。
由于焊芯在使用中的活动性很好,因此不必为避免热损坏而拖曳焊芯。相反,将焊芯放置在基板与烙铁头之间,加热2至3秒钟,然后向上抬起编织带和烙铁。抬起而不是拖曳编织带,可使焊盘遭到损坏的危险降至最低。编织带可去除所有的残留焊膏,从而排除了桥接和短路的可能性。去除残留焊膏以后,用适当的溶剂清洗这一区域。可以用毛刷刷掉残留的助焊剂。为了对新器件进行适当的回流焊,PCB必须很干净。
◆贴装器件
熟练的技术人员可以看见一些器件的贴装,但并不提倡用这种方法。如果要求更高的工艺合格率,就必须使用分光视觉系统。要用真空拾取管贴装、校准器件,并用热风进行回流焊。此时,预先编程且精密确定的温度曲线很关键。在拆除元件时,BGA最可能出故障,因此可能会忽视它的完整性。
重新贴装元件时,应采用完全不同的方法。为避免损坏新的BGA,预热(100℃至125℃)、温度上升速率和温度保持时间都很关键。与PBGA相比,CBGA能够吸收更多的热量,但升温速率却比标准的2℃/s要慢一些。
BGA有很多适于现代高速组装的优点。BGA的组装可能不需要新的工艺,但却要求现有工艺适用于具有隐藏焊点的BGA组装。为使BGA更具成本效益,必须达到高合格率,并能有效地返修组件。适当地培训返修技术人员,采用恰当的返修设备,了解BGA返修的关键工序,都有助于实现稳定、有效的返修。
为每个元件建立一条温度曲线;
b:BGA热风返修工作站拆除元件;
c:( J去除残留焊膏并清洗这一区域;
d贴装新的BGA器件。在某些情况下,BGA器件可以重复使用;
e回流焊。
当然,这三种主要类型的BGA,都需要对工艺做稍微不同的调整。对于所有的BGA,温度曲线的建立都是相当重要的。不能尝试省掉这一步骤。如果技术人员没有合适的工具,而且本身没有受过专门的培训,就会发现很难去掉残留的焊膏。过于频繁地使用设计不良的拆焊编织带,再加上技术人员没有受过良好的培训,会导致基板和阻焊膜的损坏。
◆建立温度曲线
与传统的SMD相比,BGA对温度控制的要求要高得多。必须逐步加热整个BGA封装,使焊接点发生回流。
如果不严格控制温度、温度上升速率和保持时间(2℃/s~3℃/s),回流焊就不会同时发生,而且还可能损坏器件。为拆除BGA而建立一条稳定的温度曲线需要一定的技巧。设计人员并不是总能得到每个封装的信息,尝试方法可能会对基板、周围的器件或浮起的焊盘造成热损坏。
具有丰富的BGA返修经验的技术人员主要依靠破坏性方法来确定适当的温度曲线。在PCB上钻孔,使焊点暴露出来,然后将热电偶连接到焊点上。这样,就可以为每个被监测的焊点建立一条温度曲线。技术数据表明,印制板温度曲线的建立是以一个布满元件的印制板为基础的,它采用了新的热电偶和一个经校准的记录元件,并在印制板的高、低温区安装了热电偶。一旦为基板和BGA建立了温度曲线,就能够对其进行编程,以便重复使用。
利用一些热风返修系统,可以比较容易地拆除BGA。通常,某一温度(由温度曲线确定)的热风从喷嘴喷出,使焊膏回流,但不会损坏基板或周围的元件。喷嘴的类型随设备或技术人员的喜好而不同。一些喷嘴使热风在BGA器件的上部和底部流动,一些喷嘴水平移动热风,还有一些喷嘴只将热风喷在BGA的上方。也有人喜欢用带罩的喷嘴,它可直接将热风集中在器件上,从而保护了周围的器件。拆除BGA时,温度的保持是很重要的。关键是要对PCB的底部进行预热,以防止翘曲。拆除BGA是多点回流,因而需要技巧和耐心。此外,返修一个BGA器件通常需要8到10分钟,比返修其它的表面贴装组件慢。
◆)清洗贴装位置
贴装BGA之前,应清洗返修区域。这一步骤只能以人工进行操作,因此技术人员的技巧非常重要。如果清洗不充分,新的BGA将不能正确回流,基板和阻焊膜也可能被损坏而不能修复。
大批量返修BGA时,常用的工具包括拆焊烙铁和热风拆焊装置。热风拆焊装置是先加热焊盘表面,然后用真空装置吸走熔融焊膏。拆焊烙铁使用方便,但要求技术熟练的人员操作。如果使用不当,拆焊烙铁很容易损坏印制板和焊盘。
在去除残留焊膏时,很多组装者喜欢用除锡编织带。如果用合适的编织带,并且方法正确,拆除工艺就会快速、安全、高效而且便宜。
虽然使用除锡编织带需要一定的技能,但是并不困难。用烙铁和所选编织带接触需要去除的焊膏,使焊芯位于烙铁头与基板之间。烙铁头直接接触基板可能会造成损坏。焊膏-焊芯BGA除锡编织带专门用于从BGA焊盘和元件上去除残留焊膏,不会损坏阻焊膜或暴露在外的印制线。它使热量通过编织带以最佳方式传递到焊点,这样,焊盘发生移位或PCB遭受损坏的可能性就降至最低。
由于焊芯在使用中的活动性很好,因此不必为避免热损坏而拖曳焊芯。相反,将焊芯放置在基板与烙铁头之间,加热2至3秒钟,然后向上抬起编织带和烙铁。抬起而不是拖曳编织带,可使焊盘遭到损坏的危险降至最低。编织带可去除所有的残留焊膏,从而排除了桥接和短路的可能性。去除残留焊膏以后,用适当的溶剂清洗这一区域。可以用毛刷刷掉残留的助焊剂。为了对新器件进行适当的回流焊,PCB必须很干净。
◆贴装器件
熟练的技术人员可以看见一些器件的贴装,但并不提倡用这种方法。如果要求更高的工艺合格率,就必须使用分光视觉系统。要用真空拾取管贴装、校准器件,并用热风进行回流焊。此时,预先编程且精密确定的温度曲线很关键。在拆除元件时,BGA最可能出故障,因此可能会忽视它的完整性。
重新贴装元件时,应采用完全不同的方法。为避免损坏新的BGA,预热(100℃至125℃)、温度上升速率和温度保持时间都很关键。与PBGA相比,CBGA能够吸收更多的热量,但升温速率却比标准的2℃/s要慢一些。
BGA有很多适于现代高速组装的优点。BGA的组装可能不需要新的工艺,但却要求现有工艺适用于具有隐藏焊点的BGA组装。为使BGA更具成本效益,必须达到高合格率,并能有效地返修组件。适当地培训返修技术人员,采用恰当的返修设备,了解BGA返修的关键工序,都有助于实现稳定、有效的返修。

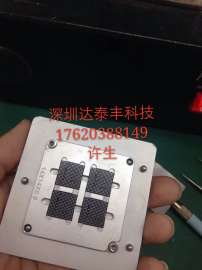



 通过认证
通过认证